在SMT贴片加工厂的生产线上,回流焊接是BGA组装工艺中较难控制的流程,设定工艺参数,获得合适的温度曲线对于BGA的良好焊接是非常重要的。由于BGA的封装形式的不同,CBGA的热阻比PBGA要大,因此达到相同的温度,CBGA比PBGA需要更高的温度设定和较长的预热时间。对于锡铅焊膏和无铅焊膏,其温度设定值和加热时间都有明显的不同。
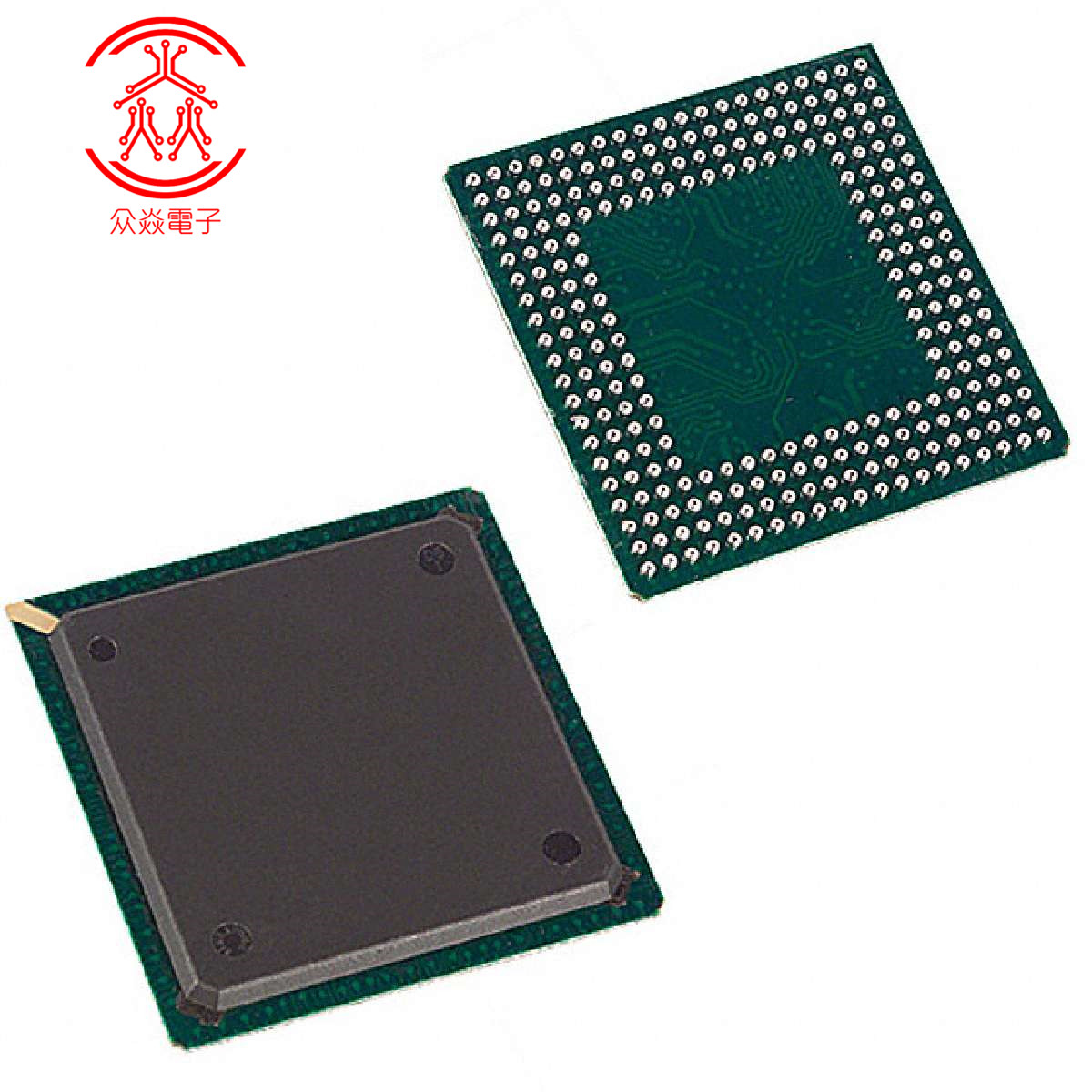
1、预热阶段
预热的主要目的是使PCB及其元器件均匀受热,同时对PCB和元器件具有烘烤的作用,除去其中的水分,以及蒸发掉焊膏中适量的熔剂。预热阶段的升温速率不能过快,以防止PCB受热过快而产生较大的变形。一般升温速率控制在3℃/s,预热时间为60—90s之间。
2、活化阶段
此阶段的主要目的是使焊膏中的助焊剂活化,除去焊盘表面和焊膏合金表面的氧化物,达到洁净的金属表面,为焊膏回流过程做好准备。同时蒸发掉焊膏中过多的助焊剂和对PCB进行预热,防止回流过程中升温过快造成PCB的变形。对于锡铅焊接,此阶段的温度在150—180℃应保持60120S;对于无铅焊接,此阶段的温度在160——200℃应保持60——180S,以便助焊剂能够充分发挥其作用。活化阶段的温升速率一般控制在0.3加.5℃/s。
3、回流阶段
此阶段焊点的温度已经上升到焊膏的熔点温度以上,焊膏处于熔融状态。回流阶段的主要目的是使熔融的焊料润湿焊盘与元器件的引脚,达到良好的焊接要求。对于PBGA,其焊球为Sn63Pb37,Sn62Pb36Ag2和Sn96.5Ag3.0Cu0.5等合金,在回流过程中焊球与焊膏一起熔化混合熔融后形成焊点;对于CBGA,其焊球为Snl0Pb90高温合金,在回流过程中焊球是不熔化的,焊膏熔化与焊盘和高温焊球润湿形成焊点。因此需要合适的时间保证熔融的焊膏能够很好的润湿焊盘和焊料球,时间过短可能造成润湿不良形成虚焊,时间过长则可能使焊料与焊盘之间形成很厚的一层金属间化合物Cu6sn5和Cu3Sn,由于其脆性的特性易形成开裂造成焊点的失效。特别是对于无铅化电子组装,由于无铅焊料中合金元素Sn的含量高,更易在高温下形成较厚的金属问化合物导致焊点的失效对于SnPb焊接,一般要求在熔点183℃以上的时间控制在60.-90s,其中峰值温度210——225℃范围内的时间控制在10—20s;对于无铅焊接,一般要求熔点217—219℃以上的时间控制在60—120S,其中峰值温度230—235℃范围内的时间控制在20—40s为佳。
4、冷却阶段
焊膏经过回流后助焊剂被完全消耗,形成了熔融的金属焊点。冷却阶段的主要目的是在焊点凝固的同时细化晶粒,抑制金属间化合物的增长,以提高焊点的强度。但由于过快的冷却速度会造成PCB的变形和电子元器件的热裂化,特别是BGA这样的吸热量大的元器件,冷却速率过快易造成内部封装的损坏,从而导致BGA的失效。一般冷却速率控制在1——3℃/s以内。
