Engelmaier通过对Coffin-Mason模型的改正,并基于Wild对于63Sn37Pb焊点热疲劳寿命统计结果,于1980年提出了无引线型电子封装热疲劳寿命预计模型,并在随后提出了有引线型封装的热疲劳寿命预计模型。焊点热疲劳故障的主要原因是由于焊点周边材料的热膨胀系数(Coefficient of Ther-mal Expansion)(CTE)不同,从而导致在热膨胀或者收缩时,各种材料产生的热应变不匹配,并在应变不协调处产生应力集中,导致裂纹的萌生和扩展,从而引起焊点的热疲劳破坏。之前已经在《SMT-PGA封装焊点热疲劳寿命预计模型研究(上)》中的Engelmaier模型进行了介绍,下面是SMT-PGA封装模型温度循环的测试。
二、温度循环测试
SMT-PGA封装模型的封装长度为27.4mm,封装宽度为27.4mm,最大引线跨度(长度方向)为25.4mm,焊点面积为0.85mm,焊点高度为0.95mm2,封装热膨胀系数为6.2×10–6/℃,PCB热膨胀系数为17.4×10–6/℃,引线弹性模量为138000MPa,引线长度为1.27mm,引线直径为0.46mm,封装焊点材料为62Sn36Pb2Ag。在CALCEPWA中共进行了7组温度循环测试。温度循环剖面见表1。由于低温驻留时间和温升时间控制为110min,温升时间为10min。
表1、温度循环剖面

1、测试结果分析
将上述信息代入到Engelmaier模型中求解,并在CALCEPWA中建立相应模型计算,相应结果见表2。在表2中给出了PGA封装在不同温循剖面下的工作最低稳态温度TCmin,表中F的值表示:当F取该值时Engelmaier模型的寿命预计结果与PWA结果吻合。
表2、模型和PWA计算结果以及F因子
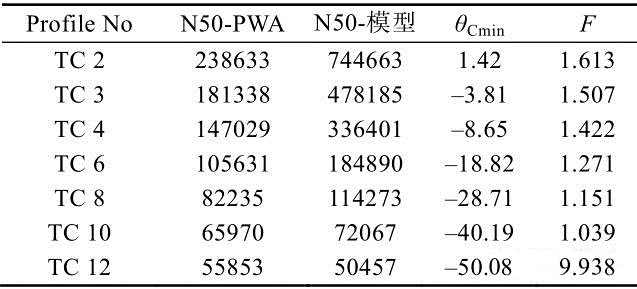
控制其他量不变的情况下,随着PGA封装工作最低稳态温度的降低,工程因子F的值也随之降低。这表明F受封装工作最低稳态温度的影响,为了更好地反应它们的关系,运用SPPS19.0进行回归分析,如图所示。

上图是工程因子与封装工作最低稳态温度关系回归分析表明,封装工作最低稳态温度与校正因子成3次方关系,拟合度R2=1。
三、结束语
运用Engelmaier模型预计SMT-PGA封装焊点的热疲劳寿命。通过与美国马里兰大学CALCE中心的CALCEPWA软件仿真分析结果比对,发现模型中的工程因子F并不是一个固定常数1,而是受封装最低稳态温度的影响,且回归分析表明工程因子与其成三次方的比例关系。
需要注意的是上述回归模型只是为了说明工程因子F与SMT-PGA封装最低稳态温度的关系,如果封装参数信息和温循剖面与表1,表2存在较大差异时上述模型求解的F并不具备一般适用性。因此在实际的工程应用中,可以通过对以往数据分析统计,建立SMT-PGA封装校正因子的模型,再运用Egelmaier模型进行寿命评估,这样可以提高模型的寿命预测结果。
