Engelmaier通过对Coffin-Mason模型的改正,并基于Wild对于63Sn37Pb焊点热疲劳寿命统计结果,于1980年提出了无引线型电子封装热疲劳寿命预计模型,并在随后提出了有引线型封装的热疲劳寿命预计模型。焊点热疲劳故障的主要原因是由于焊点周边材料的热膨胀系数(Coefficient of Ther-mal Expansion)(CTE)不同,从而导致在热膨胀或者收缩时,各种材料产生的热应变不匹配,并在应变不协调处产生应力集中,导致裂纹的萌生和扩展,从而引起焊点的热疲劳破坏。
研究表明,当CTE相差2×10-6/℃时就会出现不匹配的现象。CTE之差小于5×10–6/℃时,产品焊接的可靠性才能得到一定的保证,而较大的CTE差异往往会导致焊点在温度循环或使用过程中产生更大的应力,进而导致焊点产生疲劳裂纹直至失效。经过多年的实践检验,Engelmaier模型对于表面贴装型封装的寿命预计具有很好的适用性,IPC-SM-785andIPC-D-279也将其作为电子封装热疲劳寿命预计模型。
文中应用Engelmaier模型对SMT-PGA封装进行寿命预计,并与美国马里兰大学CALCE中心的CALCEPWA评估软件比对,一般情况针对有引线型封装,工程因子F为固定值,且F=1。然而结果表明,模型中的工程因子F并不是一个固定值,而是受封装工作的最低稳态温度的影响。文中绘制出了F与封装最低稳态温度的相关曲线,表明了F因子是如何影响模型计算结果的,这为随后的研究者提供了一种新的思路。
一、Engelmaier模型介绍
Engelmaier研究了焊点的热疲劳失效,于1980年提出了焊点热疲劳寿命预计模型,称之为Engelmaier模型,如式(1)所示:

式中:Nf为失效循环数;Δγ为焊点循环剪切应变范围;εf为焊点疲劳延伸系数;F为工程因子,对于有引线型封装一般取1;kd为引线刚度;2LD为焊点之间最大距离(对于正方形取封装长度方向引线最大跨度);A为焊点有效面积,一般取焊点实际面积的2/3;h为焊点有效高度,一般取焊点高度的1/2;c为焊点疲劳延伸指数;td为高温驻留时间;θsj为平均循环温度。

1、SMT-PGA引线抗弯刚度计算模型
SharonX.Ling和AbhijitDasgupta于1993年基于能量原理,提出了PGA封装多个引线刚度求解方法;考虑到工程实际使用时只关注引线最大刚度,通过对两种不同引线材料多个封装类型计算,表明最大引线刚度出现在同一个计算公式;因此为了简化引线刚度求解过程,PGA引线刚度按公式(4)计算。SMT-PGA封装模型如图1所示,SMT-PGA封装引线模型如图2所示。
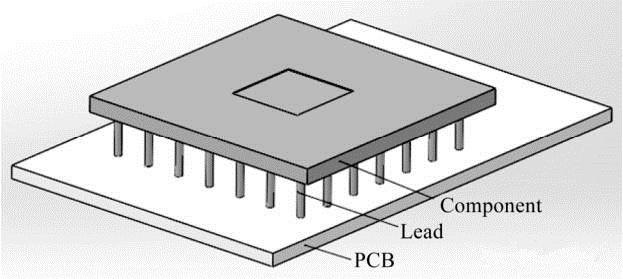

2、工程因子
F是容差系数(也称为工程因子),一般情况下针对有引线型封装F为常数,且F等于1。PerryE.Bake使用FEA求解CQFP焊点循环剪切应变范围,并代入到Engelmaier模型预测封装热疲劳寿命,最后将预测结果与试验结果比对,指出Engelmaier模型中的F因子受温度循环范围的影响,不过PerryE.Bake并未说明F与温度循环的具体关系。因此在此基础上,针对SMT-PGA封装进行进一步研究。在文中的测试中,F作为唯一的变量。根据不同的温度循环测试条件,应用Egelmaier模型预计SMT-PGA热疲劳寿命,根据CALCEPWA软件评估结果调整F因子的大小。结果表明,F因子受封装最低稳态温度的影响。
SMT-PGA封装模型温度循环的测试,将会在《SMT-PGA封装焊点热疲劳寿命预计模型研究(下)》中进行分析介绍。
