板上芯片技术(Chip-on-Board简称COB),也称之为芯片直接贴装技术(Direct Chip Attach简称DCA),是采用粘接剂或自动带焊、丝焊、倒装焊等方法,将裸露的集成电路芯片直接贴装在电路板上的一项技术。倒装芯片是COB中的一种(其余二种为引线键合和载带自动键合),它将芯片有源区面对基板,通过芯片上呈现阵列排列的焊料凸点来实现芯片与衬底的互连。
它提供了非常多的优点;消除了对引线键合连接的要求;增加了输入/输出(I/O)的连接密度;以及在印刷电路板上所使用的空间很小。与引线键合相比,它实现了较多的I/O数量、加快了操作的速度。接下来,众焱电子小编将接着《可修复底部填充技术与传统的底部填充相比较》一文中的内容继续讲解分析。
四、可靠性测试结果
对于修复操作来说最后一项工作是测试用新芯片替换原有芯片的能力。作为一项新的装配操作,修复装配应该拥有与先前一样的可靠性。为了能够确认重新替换上的倒装芯片组件在整个使用寿命期间的可靠性情况,smt贴片打样厂商需要对各种参数进行测量。符合一些确定的目标值,一般来说能够预示其具有良好的可靠性。对于底部填充材料来说,测试参数一般为测试热膨胀系数(CTE)、转变温度(Tg)、耐湿性(上升气道)以及模量。性能特性是热循环特性和粘接特性。其它需要测量的参数是最低离子容量和辐射,以及稳定的介电常数等。
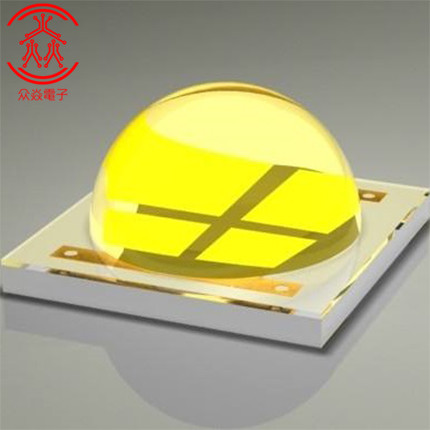
可修复底部填充材料的可靠性和性能已经被证明能够比得上传统的板级底部填充。对于CSP器件和BGA器件来说,为了能够证明原始组件和经修复组件的可靠性情况,使用了落锤试验(droptesting)。采用落锤试验进行测试的结果表明:经修复处理的组件比原始组件具有更好的可靠性。这个结果的产生是因为在修复阶段实施清除工作期间,需要对电路板的表面进行磨擦,这样就增强了粘接的效果。因为电路板的表面变得粗糙,所以可与所粘接的基板产生很强的粘接效果。
另外需要对器件进行热循环测试,以此来确认修复工作是否减弱了所替换的器件的热循环特性。对于倒装芯片组件来说,热循环测试的结果表明:在经历了超过500次的加热和冷却循环试验后,原始组件和修复位置上的器件情况类似。
五、结束语
新的可修复底部填充材料正在研究开发之中,其中包括能够兼容氮化硅酮钝化(siliconenitridepassivated)倒装芯片的材料,以及能够承受多次回流循环而不发生破裂现象的高温材料。
目前可修复底部填充材料能够很好地满足聚酰亚胺钝化管芯,但还不能够满足氮化硅酮钝化管芯的使用要求。
研究中的新的可修复底部填充材料是基于相同的具有专利权的单分子体,它可以在通常的回流温度下进行修复操作。这些材料将提供比通常的smt回流焊接温度更高的修复温度,允许底部填充材料经受多次回流温度的循环冲击,如同现在许多不可修复底部填充材料所做的那样。同时,改善可修复底部填充的操作速度的工作也在开展中。
广州众焱电子有限责任企业www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的企业,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。企业的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
