在倒装芯片制造过程中,非流动型底部填充剂主要应该考虑以下几个工艺:
1、涂敷必须覆盖形成电气接点的区域,避免在底充胶中形成多余空隙。
2、smt贴片力量必须足以将底充胶挤出,以保证焊料球与基板焊盘间形成良好接触。
3、必须对再流焊温度曲线进行优化,以确保底充胶固化前焊球得到再流,避免底充胶暴露于非正常的温度下。
在本文中,众焱电子小编主要讲解分析非流动型底部填充剂工艺中的再流焊工序。
再流焊是优化再流密封剂过程中最难控制的一步,这主要是因为很多过程同时发生并且可能在smt工艺需求上产生冲突。例如,再流焊过程中密封材料必须保持液态,以防阻碍焊点的生成和芯片的塌陷作用。同时,当电路板被送出再流焊炉时,密封剂必须实现相当程度(即便达不到完全)的固化。很多密封材料对再流温度曲线的变化非常敏感,当温度过快过高,甚至升温速率过高时,都可能造成开路。
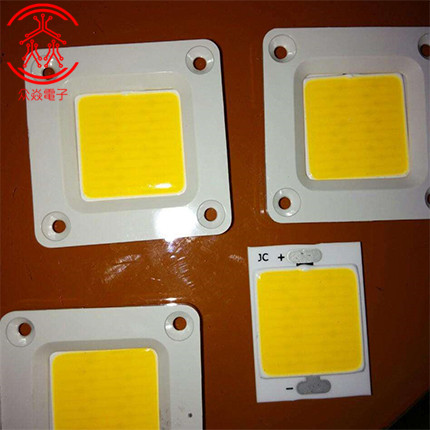
实验中所测试的密封材料需要采用传统的使smt温度曲线。这对于需同时处理其他表面贴装元件的过程很有帮助。另外,由于这些密封材料开始聚合相当“缓慢”,可以认为它们对再流焊温度曲线的敏感度最小。不过,它们在再流焊过后需要进行二次固化,一般为30至40分钟。
另一个极端的情况是,一些密封材料与传统再流焊中的“浸渍保温”期不相兼容。相反,smt贴片打样企业若将温度直接稳定升高至再流条件,并在相对较低的温度下保持几分钟,其反应的效果更佳。这一二次加热期,使得再流曲线看起来更像是传统smt再流曲线的镜像。这些材料无需二次固化,事实上二次固化过程转移到了再流焊炉内进行。
还有一类再流曲线,介于这两种极端情况之间,我们可称之为“中间”类型曲线。这种温度曲线的特点是保温期很短,甚至根本没有保温期(有时保温期温度低于常规保温温度)。其二次固化过程不在再流焊炉内部完成。其中有的需要不同时长的二次固化,有的则被设计为在再流过程中实现充分的固化。
适合于后两种温度曲线的密封剂材料固化开始时间早,因此对再流温度曲线的敏感度更高。如果密封材料过早发生固化,会因此而阻碍了凸点对其焊盘的润湿。从凸点的形貌可以看出,其他焊点此时已经塌陷,熔化的焊料被压向焊盘,正处于形成焊点的过程中。一薄层密封材料却将凸点与其焊盘隔离。采用此类密封剂时,焊点有时会呈现不规则的形貌,这是由于密封材料在焊料还处于液态时就产生凝固而造成的。
采用无二次固化的密封材料,一大问题是再流焊过程中温度曲线对固化程度的影响。由于无二次固化过程,密封剂必须在组件被送出焊炉前,从芯片塌陷到组件冷却这段很短的时间间隔内完全固化,因此即使冷却速率发生很小的变化,也会对材料的固化程度产生相当影响。密封剂固化程度降低并不会在组件从焊炉出来时被发现,但由于未固化完全的密封剂强度降低,以后可能会引发组件的可靠性问题。相对于无二次固化的密封材料,需要进行二次固化的密封材料采用相同的再流温度曲线,对冷却速率的敏感度要小得多。
再流焊过程可能使部分空隙消失,同时也可能产生新的空隙。当焊点塌陷时,密封材料被进一步挤出,这一过程将会带走周边凸点后部残存的气泡,这些气泡一旦进入焊角,便会升至密封液表面或溶解于其中。通常情况下,再流焊过程中产生的焊角没有空隙。而位于芯片下部或靠近中心凸点的气泡在焊点塌陷过程中则无法到达焊角。这些气泡消失的唯一途径,足溶解在液态密封材料中,据实验观察,气泡是溶解在置放在玻璃薄片间的密封液中的。最初的气泡尺寸越小,温度越高,气泡在密封液中的溶解效果越好;而密封液增厚将减缓其溶解过程,当密封液胶化或来自于基板的水分渗入气泡时,其溶解过程将终止。
这种情况显示了需要采用传统再流温度曲线的密封剂的另一优势。在传统温度曲线下,在相对较高的温度下保温相当的时间,为气泡的溶解提供了理想的条件。最后需要提请注意的一点,必须确保基板的干燥,否则即使在再流焊过程前期组件的所有气泡都已溶解,仍可能形成新的空隙。
广州众焱电子有限责任公司www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
