底部填充胶在使用过程中,出现空洞和气隙是很普遍的问题,出现空洞的原因与其封装设计和使用模式相关,典型的空洞会导致可靠性的下降。了解空洞形成的不同起因的及其特性,以及如何对它们进行测试,将有助于smt贴片打样厂家解决底部填充胶underfill的空洞问题。接下来,众焱电子小编就来讲解分析一下。
一、空洞的特性
了解空洞的特性有助于将空洞与它们的产生原因相联系,其中包括:
1、形状——空洞是圆形的还是其他的形状?
2、尺寸——通常描述成空洞在芯片平面的覆盖面积。
3、产生频率——是每10个器件中出现一个空洞,还是每个器件出现10个空洞?空洞是在特定的时期产生,还是一直产生,或者是任意时间产生?
4、定位——空洞出现在芯片的某个确定位置还是任意位置?空洞出现是否与互连凸点有关?空洞与施胶方式又有什么关系?
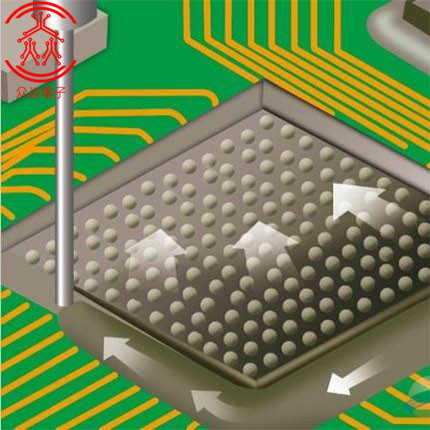
二、空洞检测方法
Underfill底部填充胶空洞检测的方法。主要有三种:
1、利用玻璃芯片或基板:直观检测,提供即时反馈,缺点在于玻璃器件上底部填充胶(underfill)的流动和空洞的形成行与实际的器件相比可能有些细微的偏差。
2、超声成像和制作芯片剖面:超声声学成像是一种强有力的工具,它的空洞尺寸的检测限制取决于封装的形式和所使用的仪器;
3、将芯片剥离的破坏性试验:采用截面锯断,或将芯片或封装从下underfill底部填充胶上剥离的方法,有助于更好地了解空洞的三维形状和位置,缺点在于它不适用于还未固化的器件。
三、空洞分析策略
先确定空洞产生于固化前还是固化后,有助于分析空洞的产生原因。
如果空洞在固化后出现,可以排除流动型空洞或由流体胶中气泡引起的空洞两种产生根源。可以重点寻找水气问题和沾污问题、固化过程中气体释放源问题或者固化曲线的问题。
如果空洞在固化前或固化后呈现出的特性完全一致,这将清晰地表明某些底部填充胶(underfill)在流动时会产生空洞,并可能不只具有一种产生源。在某些情况下,沾污可能会产生两种不同类型的空洞:它们会形成一种流动阻塞效应,然后在固化过程中又会释放气体。
广州众焱电子有限责任公司www.gz—smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
