底部填充胶在使用过程中,出现空洞和气隙是很普遍的问题,出现空洞的原因与其封装设计和使用模式相关,典型的空洞会导致可靠性的下降。在本文中,众焱电子小编主要分析底部填充胶空洞产生的原因。
一、流动型空洞
流动型空洞(其中还存在着几种子类型),都是在underfill底部填充胶流经芯片和封装下方时产生,两种或更多种类的流动波阵面交会时包裹的气泡会形成流动型空洞。
1、流动型空洞产生原因
1)与底部填充胶施胶图案有关。在一块BGA板或芯片的多个侧面进行施胶可以提高underfill底填胶流动的速度,但是这也增大了产生空洞的几率。
2)温度会影响到底部填充胶流动的波阵面。不同部件的温度差也会影响到胶材料流动时的交叉结合特性和流动速度,因此在测试时应注意考虑温度差的影响。
3)胶体材料流向板上其他元件(无源元件或通孔)时,会造成下底部填充胶(underfill)材料缺失,这也会造成流动型空洞。
2、流动型空洞的检测方法
采用多种施胶图案,或者采用石英芯片或透明基板进行试验是了解空洞如何产生,并如何来消除空洞的最直接的方法。通过在多个施胶通道中采用不同颜色的下填充材料是使流动过程直观化的理想方法。
3、流动型空洞的消除方法
通常,往往smt贴片打样厂家会采用多个施胶通道以降低每个通道的填充量,但如果未能仔细设定和控制好各个施胶通道间的时间同步,则会增大引入空洞的几率。采用喷射技术来替代针滴施胶,控制好填充量的大小就可以减少施胶通道的数量,同时有助于对下底部填充胶(underfill)流动进行控制和定位。
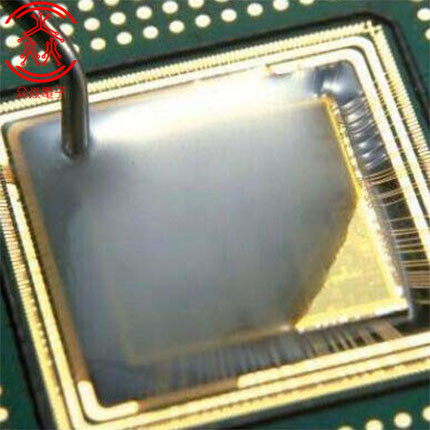
二、水气空洞
存在于基板中的水气在底部填充胶(underfill)固化时会释放,从而在固化过程产生底部填充胶(underfill)空洞。这些空洞通常随机分布,并具有指形或蛇形的形状,这种空洞在使用有机基板的封装中经常会碰到。
水气空洞检测/消除方法:
要测试空洞是否由水气引起,可将部件在100℃以上前烘几小时,然后立刻在部件上施胶。一旦确定水气是空洞的产生的根本原因,就要进行进一步试验来确认最佳的前烘次数和温度,并且确定相关的存放规定。一种较好的含水量测量方法是用精确分析天平来追踪每个部件的重量变化。
需要注意的是,与水气引发的问题相类似,一些助焊剂沾污产生的问题也可通过前烘工艺来进行补救,这两类问题可以通过试验很方便地加以区分。如果部件接触到湿气后,若是水气引发的问题则会再次出现,而是助焊剂沾污所引发的问题将不再出现。
三、流体胶中气泡产生空洞
对流体胶材料的处理不当、重新分装或施胶技术不当都会引发气泡问题。在使用时未经充分除气。而一些自动施胶设备如果没有设定好的话,也会在施胶时在其流动途径上产生气泡。
材料气泡检测方法:
1、有一种直接的方法可以检测底部填充胶(underfill)材料中是否存在着气泡,可通过注射器一个极细的针头施胶并划出一条细长的胶线,然后研究所施的胶线是否存在缝隙。如果已经证实底部填充胶(underfill)材料中存在气泡,就要与你的材料供应商联系来如何正确处理和贮存这类底部填充胶(underfill)材料。
2、如果没有发现气泡,则用阀门、泵或连接上注射器的喷射头重复进行这个测试。如果在这样的测试中出现了空洞,而且当用注射器直接进行施胶时不出现空洞,那么就是设备问题造成了气泡的产生。在这种情况下,就需要和你的设备供应商联系来如何正确设置和使用设备。
四、沾污空洞
助焊剂残渣或其他污染源也可能通过多种途径产生空洞,由过量助焊剂残渣引起的沾污常常会造成不规则或随机的胶流动的变化,特别是在互连凸点处。如果因胶流动而产生的空洞具有这种特性,那么需要慎重地对清洁处理或污染源进行研究。在某些情况下,在底部填充胶(underfill)固化后助焊剂沾污会在与施胶面相对的芯片面上以一连串小气泡的形式出现。显然,底部填充胶(underfill)流动时将会将助焊剂推送到芯片的远端位置。
广州众焱电子有限责任公司www.gz—smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
