经过近十余年来电子制造业的蓬勃发展,我国的现代电子制造装联工艺技术已自行体系。按照优胜劣汰、去伪存真、去粗存精、质量、效率、敏捷、精益、可靠的原则,先虚拟一条有中国特色的示范智能SMT贴片加工生产线的仿真方案。再经过深入的技术分析和论证后使其实体化。这样就有可能使我国由电子制造大国向电子制造强国的奋斗中,实现跨越发展,弯道超车,少走甚至不走弯路的效果。下面众焱电子小编将接着《SMT组线工序智能化的解决方案之再流焊接智能控制》的内容继续分析讲解。
3、BGA的监控
BGA器件的组装是一种基本的物理连接工艺过程,在检测BGA缺陷中,物理电测仅能确认BGA连接的通或断。而非物理的3DXay分层法焊点测试,能在线查出隐藏的焊点缺陷。了解和判断影响其长期工作可靠性的物理因素,如:钎料量、焊端与焊盘的定位和润湿性,以及在组装过程中形成可靠连接的能力。这些测试所提供的反馈信息影响到每个工艺过程的调整,或者要变动焊点的参数。例如,在再流焊接期间,极度的环境湿度伴随着冷却时间的变化,将在BGA焊点内的空洞数量和尺寸大小上迅速反映出来。
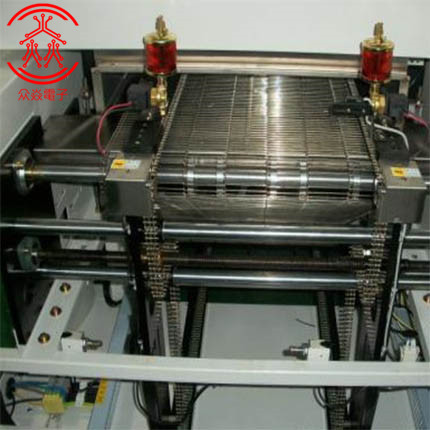
3DXay射线分层法通过在BGA连接点的二个或更多个不同的高度(例如:在PCB焊盘接触面、元器件焊盘接触面,以及在上述二面之间的一半高度上)所作的水平横截面图像反映出来。再结合同类BGA连接点的多次切片测量数据,就能有效地建立三维测试数据,实现在不进行破坏性的物理横截面切片操作的情况下,对BGA连接点进行检测。根据BGA连接点的常规结构,在每个横截面X射线“切片”图像内,对具体连接点的特征进行分离并予以测量。从而提供定量的统计工艺控制(SPC)数据,SPC测量能够用于追踪过程偏移,并将其特征值归入对应的缺陷范畴。
通过X射线分层法切片,在BGA焊接点处可以获取如下四个基本的物理测试参数:
1)焊点中心的位置:焊点中心在不同图像切片中的相对位置,表明元器件在PCB焊盘上的定位情况。
2)焊点半径:焊点半径测量表明在特定层面上焊点中钎料的相应数量。对焊盘层半径的测量表明在焊膏印刷工艺过程中,以及因焊盘污染所产生的任何变化。而对焊球半径的测量,可以反映元器件的共面性或者PCB的变形。
3)同中心的环线厚度:以焊点为中心取若干个环线,测量每个环线上钎料的厚度和它们的各种变化率,可以展示焊点内的钎料分布情况,利用这些参数可辨别焊点润湿状况的优劣和空洞的存在情况。
4)焊点形状相对于圆环的误差(也称为圆度):焊点的圆度可以显示钎料围绕焊点中心分布的匀称情况,作为同心圆,它反映与中心对准和润湿的情况。
4、结语
总的来说,上述测试所提供的信息数据,对于广州SMT贴片加工厂确定焊点结构的完整姓,以及了解BGA组装工艺过程中,每个步骤的性能情况是非常重要的。掌握了这些在BGA组装过程中,所提供的信息和这些物理测试之间的相互关系,就能够防止位移现象的产生,改善相关的工艺过程,以消除缺陷现象的产生。
广州众焱电子有限责任公司www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
