为解决BGA封装器件的电装问题,通过对CBGA器件进行焊接,对焊点质量和可靠性进行分析和评价,确认器件装联工艺的可行性和适用性,摸索可靠的工艺方法,使其应用于航空电子产品的生产中。CBGA焊接是个复杂的工艺过程,其在SMT贴片加工厂中需要关注的环节较多,其中包括:焊盘设计、焊膏量的控制、SMT贴片精度要求、BGA器件焊接方法、温度曲线、焊接界面表面状态的选择等,下面是接续《CBGA器件组装工艺研究(上)》剩下的几个环节。
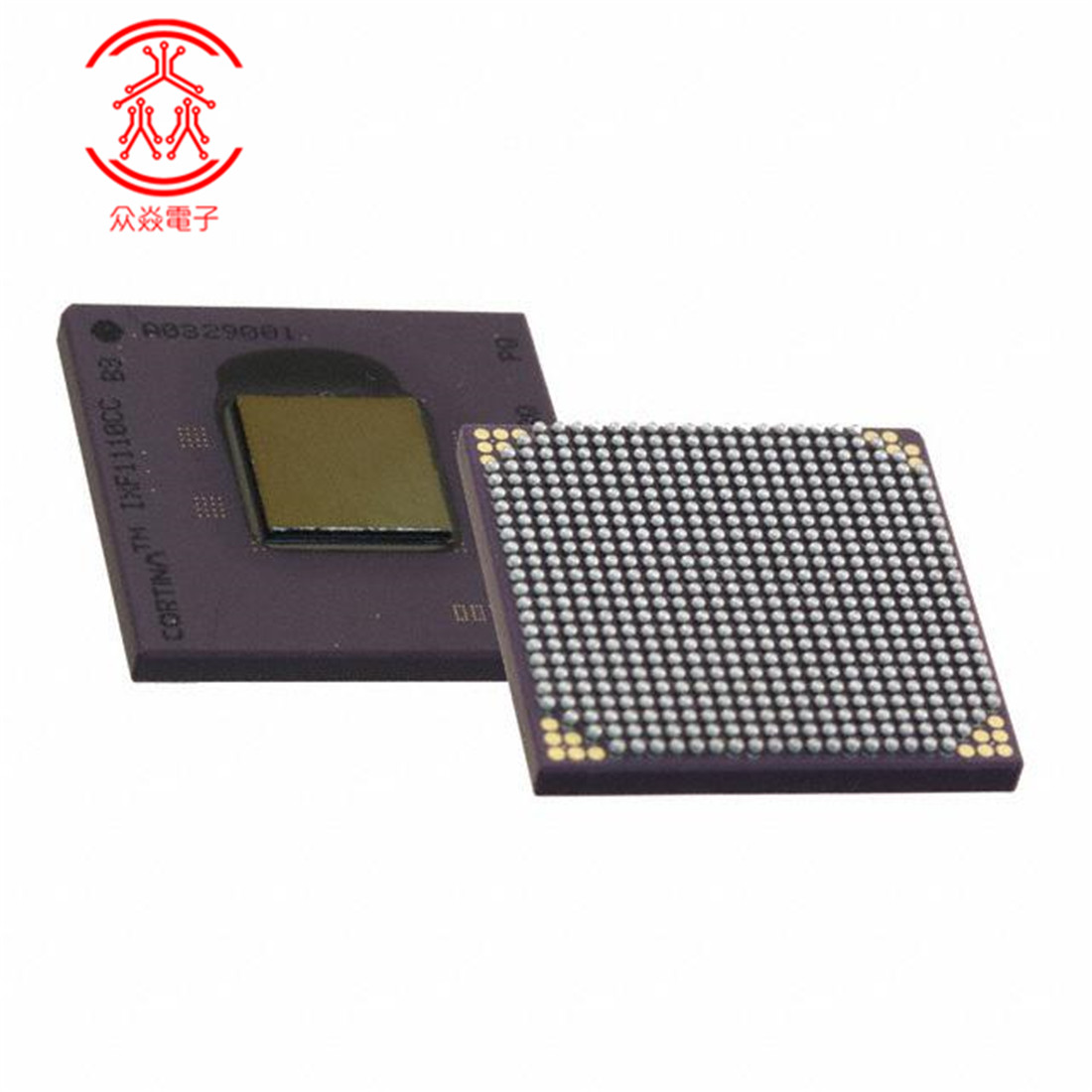
4、BGA器件焊接方法
用于表面安装的再流焊接按照加热方法不同分为三大类,即红外热风再流焊、汽相再流焊和激光再流焊。激光再流焊一般只适用于焊点外露于表面的焊接;而CBGA器件引脚全部在器件本体的底部,所以从CBGA器件焊接的原理上可以采用红外热风再流焊接和汽相再流焊接两种焊接方式。红外热风再流焊的应用较广,工艺曲线已成熟,焊点光亮,但因为器件本体的遮挡,无法完全均匀一致的对底部引脚进行加热。汽相再流焊利用加热高沸点液体作为转换介质,利用它沸腾后产生的饱和蒸汽来加热工件,达到焊接所需温度。汽相再流焊的高温饱和蒸汽可使组件均匀加热,尤其对于大型的BGA、CCGA等焊点在底部的复杂封装器件焊接十分有利。另外因为焊接过程中,组件处于高温汽相蒸汽中,隔绝了氧气,有利于形成高质量焊点。
5、温度曲线是决定焊接质量的关键
选用汽相再流焊炉进行焊接。再流焊接是BGA组装过程中关键步骤,再流焊接过程分预热过程、保温过程、再流过程、冷却过程,由这四个过程组成一个焊接曲线,这四个过程温度和时间合理设置才能形成一个良好焊点。
由于CBGA器件引脚密集的引脚,使得外层引脚和内层引脚间的温度有一定差别,所以保证有良好内层引脚和外层引脚同时达到良好的焊接温度和保温时间,同时器件又不能超过允许的焊接温度和时间,这是在工艺改进中需要重点解决的关键技术问题。加热方式不同,对焊接温度及各种不同封装器件原来设定的焊接条件,在实际焊接时的温度曲线会发生一定的变化,正式焊接前,需进行温度曲线的测试。
6、焊接界面表面状态的选择
BGA器件由于储存原因,焊接前会出现其引脚焊接界面状态不均匀,分析是氧化造成的。BGA器件引脚有氧化现象,焊膏对该表面润湿性就变差,严重时可能不润湿,二者不能熔为合金,在焊料和连接面被氧化膜隔离,焊点强度很低,尽管有局部接触暂时表现为导通,但在温度交变或振动等外力作用下该焊点界面很容易被拉脱,形成开路。
7、三防与粘固
为了进行环境试验,对BGA器件进行了固封。BGA器件采用底部填充聚氨酯胶的方式,填充前聚氨酯胶需抽真空排除气泡。填充采用“L”型(即器件相邻两边)填胶的方法,通过毛细作用使胶液流过器件底部,可保证元器件底部无气泡存在,如果BGA器件四角有足够空间,可以采取四角先点环氧胶后再填充。
