随着电子产品向便携化、小型化、网络化和高性能方向的发展,BGA器件由于其独特的优越性在SMT贴片加工厂的各种型号产品中,得到了越来越广泛的应用,该类器件封装由于自身特点,只能采用专用设备进行焊接和检测。由于其节距越来越小,焊装难度越来越大,工艺要求也越来越高。另一方面,由于其检测设备价格昂贵,使该类器件的焊接质量的检测相对困难。
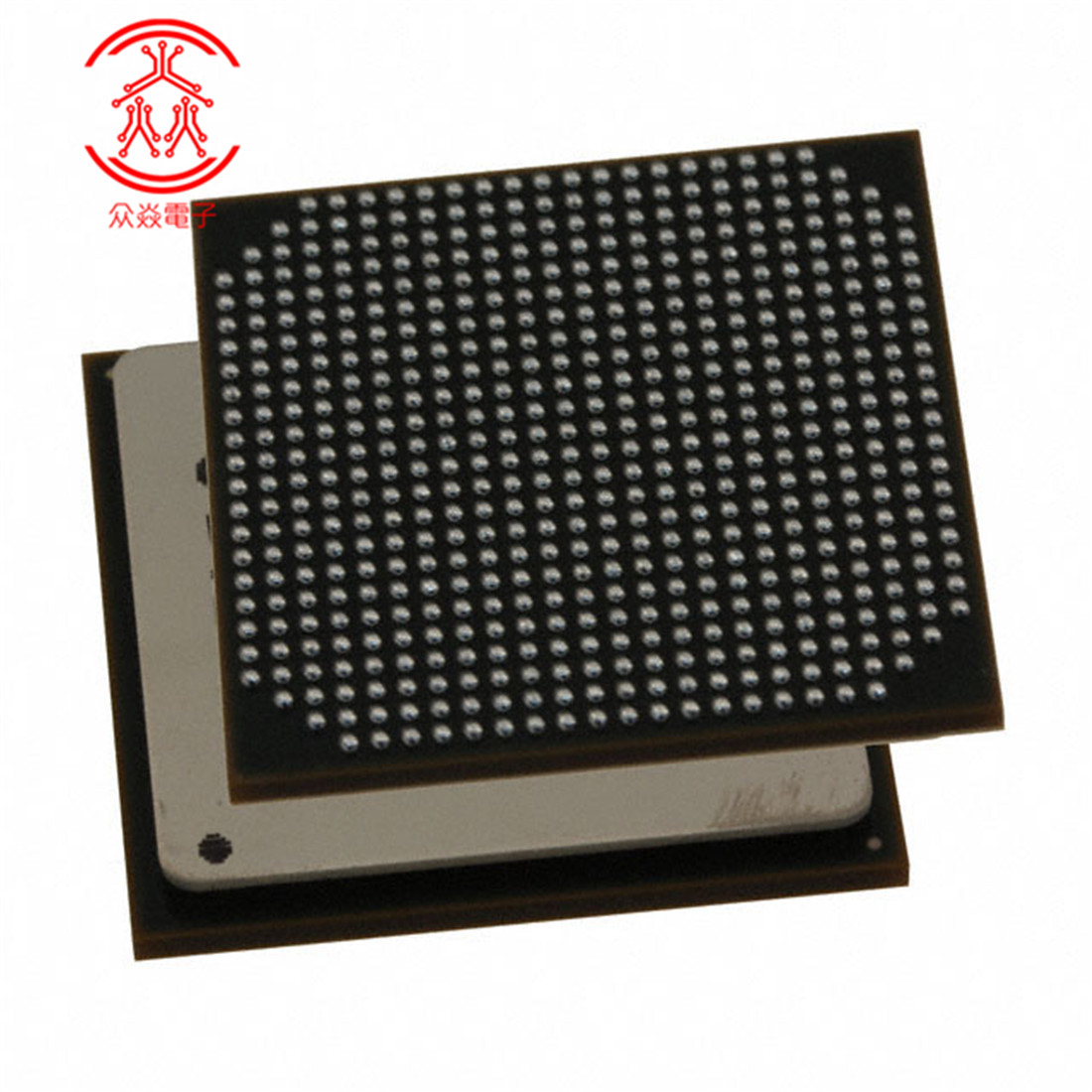
1、目视检查
通过10X-40X光学显微镜进行焊点外观形貌检测,BGA形成连续、坚固的椭圆焊点,并且顺着泪滴形焊盘有润湿。CGA焊柱应与焊料润湿良好,形成连续焊点,并且焊点顺着泪滴形焊盘有润湿。BGA可检测的常见缺陷有:短路、开路(虚焊)、焊锡珠、错位、空洞等。
2、内部焊点焊接检测
内部焊接情况可以通过X-ray检测,倾转一定的观测角度,直到避开高铅柱列的阻挡,可以观察SnPb共晶焊点部分。而本试验采用的CBGA器件引脚为90Pb10Sn,由于焊接后引脚在焊接过程并不熔化,铅锡引脚的厚度足以阻挡X射线,通过X射线检测只能检测器件引脚间是否有桥连,焊点及内部形状无法看到。
3、电性能测试
组装件完成焊接后,进行了电性能测试。首先对对测试片通过菊花链进行通断电性能测试,及时发现问题,确定其具体位置,分析原因,优化设置。无源元件应进行功能性测试,可采用菊花链。须无信号丢失;阻抗连续变化须少于10%(在室温下测试)。
4、温度循环测试
1)热循环要求:-55~100℃,温变速率不应超过10℃/min,极限温度至少保持15min,每个循环1小时,200个循环,阵列器件需要做500个温度循环。
2)试验样件在做温循前应进行预烘去潮,温度60℃~80℃。
3)温度循环可在振动试验前或后完成。振动试验可在任何数量个温度循环后完成。
CBGA在电子装联中的直通率可以达到很高水平,焊接缺陷很大部分是由于器件的自身缺陷等原因造成的。整体可靠性取决于最薄弱的一环,工艺控制要重点关注薄弱环节。
