PCB是现代电子产品不可缺少的材料,随着smt贴片加工技术、集成电路(IC)技术的高速发展,PCB需要满足高密度、高平整化、高可靠性、更小孔径、更小焊盘的发展要求,对PCB表面处理和制作环境的要求也越来越高。OSP表面处理是目前常见的一种PCB表面处理技术,是在洁净的裸铜表面上,以化学的方法长出一层0.2~0.5um的有机皮膜,这层膜在常温下具有防氧化、耐热冲击、耐湿性,可以保护铜表面发生氧化或硫化的作用,在后续的高温焊接中,此种保护膜又必须很容易地被助焊剂所迅速清除,露出干净的铜表面在极短时间内与熔融焊锡结合成为牢固的焊点。接下来,众焱电子小编就来详细的讲解分析一下。
一、问题描述
在实际smt贴片打样或加工生产过程中,OSP板容易出现表面变色、膜厚不均匀、膜厚超差(太厚或太薄)等问题;在PCB制作的后期阶段,已成型的PCB如储存和使用不当容易出现焊盘氧化、焊盘上锡不良、不能形成牢固的焊点、虚焊及焊锡不饱满等焊接问题;smt生产双面板第二面及锡炉焊接时容易出现回流焊接不良、焊点漏铜、外观满足不了IPC3级标准、锡炉焊接不良率高等问题。
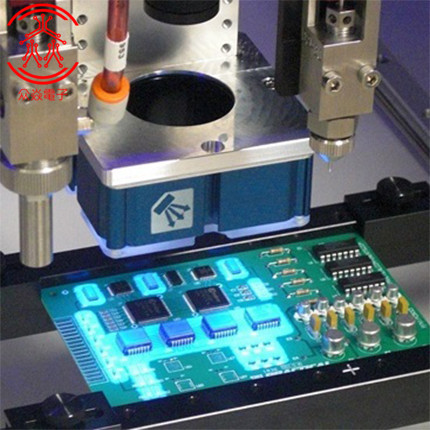
二、案例分析
smt贴片打样厂商的某OSP表面处理PCB产品在smt贴片生产第一面时元件焊盘上锡良好,在生产第二面时出现过炉后连接器及部分位置元件焊盘上锡不良,焊料在焊盘上出现一定的反湿润和拒焊问题。本案例中的PCB是OSP表面处理方式,smt贴片制程是无铅工艺,根据基本焊接原理及实际工程经验分析,拒焊及反湿润出现与PCB表面焊盘的可焊性有直接的关系。因此,本案例的分析思路是首先通过外观检查,再分别使用异丙醇(清洗IPA)和盐酸清洗不良焊盘进行可焊性对比,再借助第三方实验室使用EDS进行成分分析等方法,找出OSP可焊性差的原因,并给出相应的改善对策。
三、分析过程
1、使用显微镜观察不良品,发现PCBA上存在多处润湿不良,润湿不良焊盘上呈球状、不规则网状,PCBpad呈现明确的不可焊形貌。
2、使用异丙醇(IPA)对润湿不良焊盘进行清洗,清洗后浸入255OC锡槽5秒钟。验证目的:如为异物污染导致的不润湿,IPA清洗后可以润湿上锡。结论:IPA清洗无助于焊盘上锡,说明焊盘不上锡不是异物覆盖导致的。
3、使用盐酸对润湿不良焊盘清洗,清洗后浸入255OC锡槽5秒钟。验证目的:如为焊盘氧化导致的不润湿,盐酸清洗后可以润湿上锡。结论:盐酸清洗后焊锡润湿良好,说明不润湿焊盘表面存在金属氧化物,导致焊接过程中焊锡无法润湿。
4、对拒焊位置做EDS分析。验证目的:对拒焊焊盘表面不良位置元素成分进行分析,确定导致上锡不良的根本原因。结论:不上锡焊盘区域铜占绝对优势,说明未被焊锡覆盖,无其它金属污染;拒焊区域焊锡边缘区域存在碳氧等元素,是焊接过程及空气中成分影响所致。
5、PCB可焊性测试。依照IPCJ-STD-003B中测试A1的方法,对同周期的PCB光板及光板模拟过一次回流焊后再进行可焊性测试。验证目的:对比光板和模拟过一次回流炉后PCB可焊性的差异。结论:同周期PCB光板,焊盘上锡良好,外观符合IPC要求;经过一次回流之后OSP膜劣化减薄,PCB可焊性变差,部分焊盘润湿不良。
四、综合分析结论
PCB板面存在多处拒焊现象,拒焊区域经异丙醇清洗无效,证明无异物覆盖焊盘;盐酸清洗后可以正常润湿,证明焊盘表面存在金属氧化物,该氧化层影响焊接效果;对焊盘拒焊区域做EDS成分分析,结果显示主要成分为铜、碳、氧,证明拒焊焊盘表面存在金属氧化层,无其它金属污染物及其它覆盖物;对比模拟一次回流焊的光板作可焊性验证,发现部分焊盘可焊性变差,有润湿不良的现象。
经过上面的综合分析,此案例为OSP膜厚不够及不耐多次高温导致。新拆封的OSP板保护膜完好,未出现焊盘氧化现象,焊锡润湿性良好。经过一次回流高温后OSP膜受热分解减薄,部分区域OSP膜损耗殆尽,无法有效保护焊盘铜箔导致焊盘氧化,焊接时出现拒焊现象。需要PCB厂商加强OSP工艺过程控制,严格管控OSP膜的厚度及均匀性。
广州众焱电子有限责任公司www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务
