在电子焊接过程中有很多问题产生在BGA元器件,本文就摘取实际的案例有助于帮助大家梳理解决的方法,供参考借鉴。
某一广州SMT贴片加工厂生产的一种产品,在C2线QA测试时发现有4PCSP3显示不良,经确认分析为BGA北桥空焊,投入数:400PCS,不良板数为4PCS,不良率:1.0%。查SMT投入状况:生产线体:FS301线,投入数:5000PCS,返工后总不良数:15PCS,不良率:0.03%。下面众焱电子小编将接着《BGA空焊异常原因调查和改善对策》的内容继续分析讲解
5、对不良板进行破坏性试验,如图4所示。
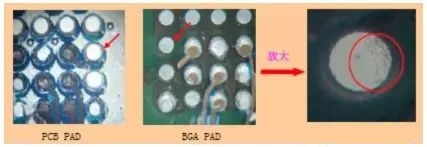
图4 对不良板进行破坏性试验
1)取一片不良板通过外力强行将该位置的元件剥离,剥离后对不良位置的焊点进行确认:不良位置上锡球与PCB焊盘焊接良好,无少锡、假焊现象(如图4:PCBPAD)。
2)对取下的BGA焊点进行确认:(BGA本体上的)不良点位置的锡球被完全剥离,并且BGA焊点位的置表面有轻微发黑受污染现象,说明不良发生在BGA锡球与BGA本体连接处,初步判定为:BGA在植球过程受污染导致BGA锡球焊接强度不够,在过回流炉焊接过程中受表面张力的作用导致BGA锡球被剥离脱落(如图4:BGAPAD)。
6、对制程条件进行确认,此机种为混合制程:有铅制程,无铅物料(北桥BGA)。
二、原因分析
1、根据以上调查,说明SMT贴片加工制程条件相当稳定,无异常;
2、取2PCS不良板,直接通过加热维修,加热后重新测试OK,无不良,说明了BGA空焊为BGA锡球脱离造成,重新加热后二次焊接后OK。
综合以上调查,导致北桥BGA空焊不良原因为:BGA物料异常,BGA在植球过程中焊盘受污染,导致该元件的锡球焊接强度不够,在过炉二次焊接过程中锡球脱离造成。

图5 BGA空焊不良原因
三、改善对策和结果
1、临时对策
根据以上不良现象,现对FS402线生产的机种进行更改炉温试验,其更改内容:北桥中心温度由237.1度提高到240度,延长回流炉焊接时间(大于220度时间):由85S更改为90S,通过更改炉温设定、提高焊接能力来改善(因BGA物料异常造成的空焊)不良。
2、恒久对策
由品管跟进不良物料投入使用状况。
3、跟进结果
1)更改炉温,物料不变不良率由1.0%下降到0.62%,不良有所下降,但不能完全杜绝;
2)更换不同LOTNO的物料试验跟进,更换(LOTP712.00)物料后生产1500PCS,无不良。
广州众焱电子有限责任公司www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
