花球焊盘BGA芯片,其外封装焊球直径相同,但是焊盘设计有许多种,在SMT组装过程中对回流焊温度曲线的设置、模板开孔方案以及焊膏的选择等,都提出了很高的要求。在SMT贴片加工工艺质量控制相当成熟的今天,BGA的焊接一直是重要关注的环节。一个OEM工厂的制程能力,在很大程度上取决于BGA的焊接水平。
电子行业的特点是:元件功能在不断的升级换代,电子产品的性能越来越强大,而外形、体积却越来越小。甚至有的元件采用了更为先进的工艺。这些元件、产品的变化给SMT生产制造不断提出挑战。下面众焱电子小编将接着《SMT制程之花球焊盘BGA焊接技术研究(一)》中的内容继续进行分析讲解。
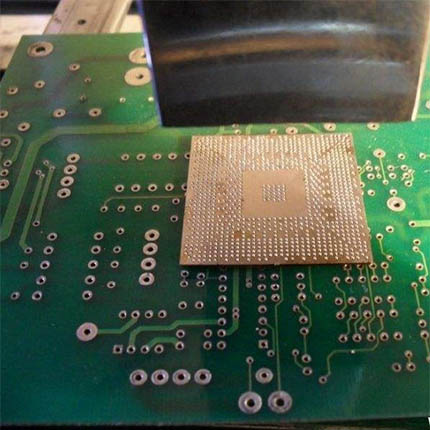
2、网板开口
由于基板变薄和整体封装厚度变薄导致封装翘曲度增加,在回流焊期间,芯片焊球和PCB焊盘锡膏会出现较大的相对位移,需要调整模板开口面积进行补偿。封装在PCB期间弯曲,出现弯曲变形严重的部位是芯片的四周和中心部位。这些部位需要通过改变网板孔面积来减少锡球缺陷:通过扩大网板开孔,进而增加了锡膏体积,可以弥补这些部位因为BGA焊球远离PCB焊盘而导致的焊膏欠缺,确保焊球和焊盘锡膏之间形成良好的焊接。反过来的情况是,在封装的扭曲严重的位置和对PCB有压缩的地方,BGA和PCB贴合太近,锡膏可能被挤压变形了。在这种情况下,就需要减小网板孔而减少锡膏量,以便防止出现桥接缺陷。而对于其他部分的网板孔径大小可以是1:1开口比例。
3、锡膏的选择
根据BGA的特性可以知道,BGA本体在焊接过程中存在着热变形的现象。再流焊接加热与冷却过程中,如果BGA的载板与芯片(Die)、封装材料的,热膨胀系数(CTE)相差比较大,它就会发生热变形。随着加热温度的升高,逐渐变为四角上翘,随着温度的下降,又逐步恢复到室温下的状态。花球焊盘弓形芯片的焊球直径很小,一般在0.35MM,焊球本身体积很小,相应的焊盘上的焊膏量就很有限。相信很多广州SMT贴片加工厂都遇到过一个情况,即体积越小的物体表面积越大,其在焊接过程中,这些焊料中助焊剂因为过大的表面积挥发迅速,焊料非常容易失去活性。当焊料体积不足时,在BGA的变形的情况下,焊料就会被拉伸,如果和焊球分开,孤立的焊膏体积很小,助焊剂不足,很容易失效。基于以上的考虑,选用黏着力大,助焊剂活性强的锡膏。锡膏黏着力大,芯片变形时锡膏也一起拉伸,锡膏和焊球不容易分离;锡膏活性大,弥补锡膏量体积小助焊剂容易挥发的缺陷,有助于防止枕头效应(HoP)和无润湿开焊(NWO)等现象的出现。
未完待续…
广州众焱电子有限责任公司www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的公司,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。公司的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
