由于集成电路的集成度迅猛增加,导致芯片发热量急剧上升,使得芯片寿命下降。据报道,温度每升高10℃,因GaAs或Si半导体芯片寿命的缩短而产生的失效就为原来的3倍。其原因是在微电子集成电路以及大功率整流器件中,材料之间散热性能不佳而导致的热疲劳以及热膨胀系数不匹配而引起的热应力造成的。
解决该问题的关键是进行合理的封装。电子封装材料主要包括基板、布线、框架、层间介质和密封材料,最早用于封装的材料是陶瓷和金属,随着SMT工艺技术、电路密度和功能的不断提高,对封装技术提出了更多更高的要求,同时也促进了封装材料的发展。封装材料起支撑和保护半导体芯片和电子电路的作用,以及辅助散失电路工作中产生的热量。
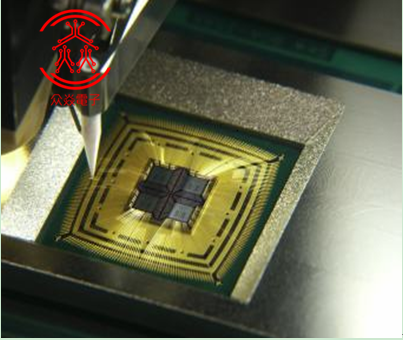
作为理想的电子封装材料必须满足以下几个基本要求:
1、低的热膨胀系数;
2、导热性能好;
3、气密性好,能抵御高温、高湿、腐蚀和辐射等有害环境对电子器件的影响;
4、强度和刚度高,对芯片起到支撑和保护的作用;
5、良好的加工成型和焊接性能,以便于加工成各种复杂的形状;
6、对于应用于航空航天领域及其他便携式电子器件中的电子封装材料的密度要求尽可能的小,以减轻器件的质量。
常用的电子封装材料有塑料、陶瓷、金属、金属基复合材料。
现在的集成电路向小型化、高密度组装化、低成本、高性能和高可靠性发展,这就对基板、布线材料、密封材料、层间介质材料提出了更高的要求,需要性能好,低成本的电子封装材料的出现。这对金属基电子封装符合材料的发展提供了巨大的空间。
通过改变金属基复合材料中增强体的形状、大小、体积分数,寻找一种不仅与基板的热性能相匹配,又具有良好力学性能,而且制造方法还经济适用的电子封装材料,是研究金属基电子封装复合材料的发展方向。
