如果这个温度差比较大,就可能引起焊接不良,如QFP引脚的开焊、绳吸;片式元件的立碑、移位;BGA焊点的收缩断裂等。同理,我们可以通过改变热容量解决一些问题。
1、热沉焊盘的热设计
在热沉元件的焊接中,会遇到热沉焊盘的少锡的现象,这是一个可以通过热沉设计改善的典型应用情况。
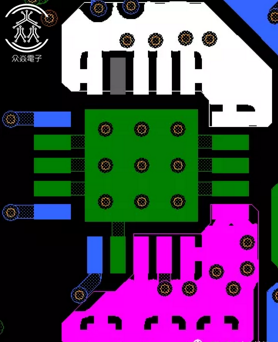
2、大功率接地插孔的热设计
在一些特殊产品设计中,插装孔有时需要与多个地/电平面层连接。

为了避免这种情况发生,经常用到一种叫做星月孔的设计,将焊接孔与地/电层隔开,大的电流通过功率孔实现。
3、BGA焊点的热设计

根据案例提供的经验,一般发生收缩断裂的焊点位于BGA的角部,可以通过加大BGA角部焊点的热容量或降低热传导速度,使其与其他焊点同步或后冷却,从而避免因先冷却而引起其在BGA翘曲应力下被拉断的现象发生。
4、片式元件焊盘的设计
片式元件随着尺寸越来越小,移位、立碑、翻转等现象越来越多。这些现象的产生与许多因素有关,但焊盘的热设计是影响比较大的一个方面。
如果焊盘的一端与比较宽的导线连接,另一端与比较窄的导线连接,那么两边的受热条件就不同,一般而言与宽导线连接的焊盘会先熔化(这点与一般的预想相反,一般总认为与宽导线连接的焊盘因热容量大而后熔化,实际上宽的导线成了热源,这与PCBA的受热方式有关),先熔化的一端产生的表面张力也可能将元件移位甚至翻转。
5、波峰焊接对元件面的影响

0.8mm及其以上引脚中心距的BGA大部分引脚都是通过导通孔与线路层进行连接的。
波峰焊接时,热量会通过导通孔传递到元件面上的BGA焊点。根据热容量的不同,有些没有熔化、有些半熔化,在热应力作用下很容易断裂失效。
②片式电容:
片式电容对应力非常敏感,容易受到机械和热应力的作用而开裂。随着托盘选择波峰焊接的广泛使用,在托盘开窗边界处的片式元件很容易因热应力而断裂。
广州众焱电子www.gz-smt.com,是一家专业从事SMT贴片加工、DIP常见加工、PCBA包工包料、PCB线路板制造的企业,拥有多年的电子加工经验,以及先进的生产设备和完善的售后服务体系。企业的SMT贴片加工能力达到日产100万件,DIP插件加工产能为20万件/日,能够给你提供优质的电子加工服务。
