根据《SMT加工中增加锡膏量可以改善BGA焊接不良?》中所说的经验,以及许多SMT贴片加工厂的前辈们做过的实验显示,增加BGA的焊锡量可以有效降低这类因为温度造成板材变形所造成的HIP问题。可是要小心锡膏量如果增加太多反而会造成焊接短路的问题,不可不慎。
众焱电子选择的方法是局部增加BGA的锡膏量而不是全部的锡球焊垫都增加锡量。
改变BGA的锡膏量可以从钢板来下手,基本原则就是让BGA最外一排或四个角落的锡球锡膏印刷量,比剩馀的其他锡球的锡膏量来得多,可是又不能多太多,这样才可以在PCB与BGA本体变形时还保有足够的锡膏与BGA底下的锡球接触到。
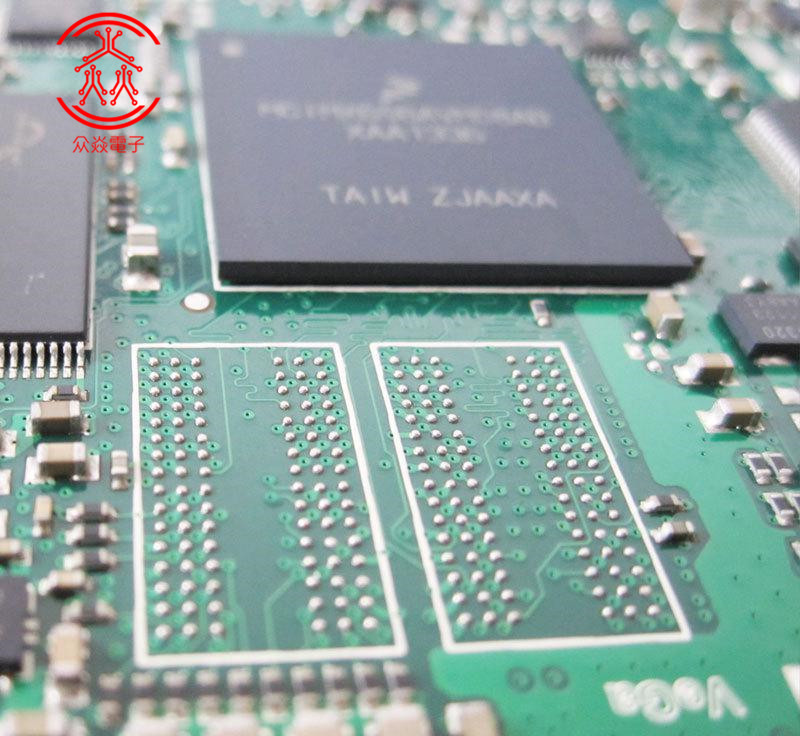
1、当BGA锡球大于0.4mm:
将BGA外围四个面的锡球锡膏印刷量增加,把钢板开成正方形与原来锡球圆焊垫形成一个内接圆,其他的锡球焊垫维持原来的量。
2、当BGA锡球小于0.4mm:
BGA外围四个面的锡球锡膏印刷维持不变,但是其他内围的锡球则减少锡膏量,将钢板开成正方形与原来锡球圆焊垫形成一个外接圆。
如此一来,不论是那种尺寸的BGA,其最外围一圈锡球的锡膏量都会比内圈的锡膏量多出16.7%左右,用来确保PCB与BGA本体流经高温变形时还有足够的锡膏可以保持与BGA底下的锡球互相接触。
BGA锡球尺寸小于0.4mm,采用降低BGA内围袭球的锡膏量所得到X-Ray,稍微留意一下可以发现最外圈的锡量(圆的直径)比其他内围的锡球上的锡量来得多一点点。也就是外圈的黑色圆形直径比内圈的圆形来得大一点点。
