BGA是一种目前常用的封装形式,以其多I/O,引脚短,体积小的优点迅速发展,BGA封装技术主要适用于PC芯片组、微处理器/控制器、ASIC、门阵、存储器、DSP、PDA、PLD等器件的封装。但因其引脚在BGA下表面,使得其返修的难度增大,且返修工艺也比较复杂。随着长期的使用,当BGA的引脚磨损,会导致相关元器件的功能出现问题。
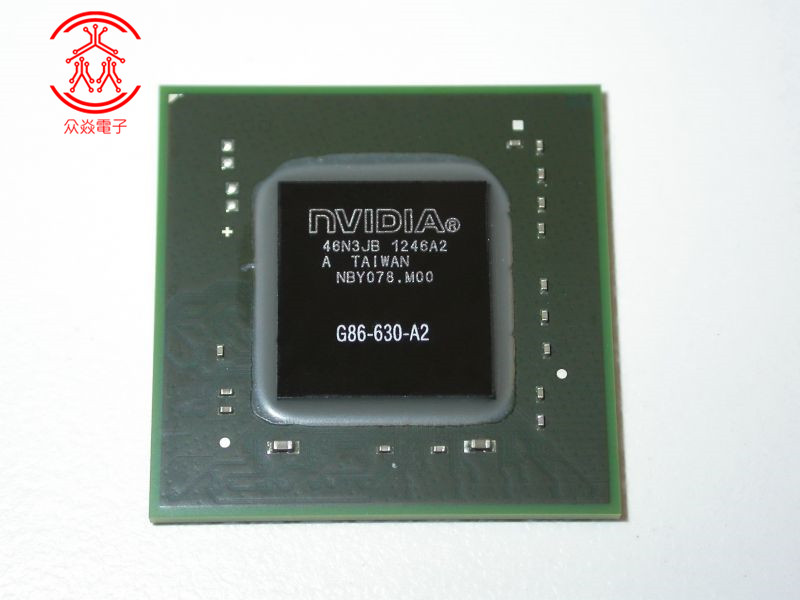
1、芯片翘曲
BGA出现焊接缺陷后,如果进行拆卸植球焊接,总共经历了SMT回流,拆卸,焊盘清理,植球,焊接等至少5次的热冲击,接近了极限的寿命,统计发现最终有5%的BGA芯片会有翘曲分层,所以在这几个环节中一定要注意控制芯片的受热,拆卸和焊盘清理和植球环节中尽量降低温度和减少加热时间。
2、PCB翘曲
热风工作站采用上下部同时局部加热来完成BGA的焊接,由于PCB材质的热胀冷缩性质和PCB本身的重力作用,因而对PCB中BGA区域产生更大的热应力,会使得PCB在返修过程中产生一定程度上的翘曲变形,支撑虽然起了一定的作用,但PCB变形仍然存在。严重时这种变形会导致外部连接点与焊盘的接触减至最小,进而产生BGA四角焊点桥接,中间焊接空焊等焊接缺陷。因此要尽量控制温度,由于工作站底部加热面积较大,在保证曲线最大温度和回流时间条件下,增加预热时间,提高底部加热温度,而降低顶部加热温度,会大大的减少PCB的热变形;另外就是注意底部支撑放置的位置和高度。
3、焊接开路
造成焊接开路的原因比较复杂,上面论述的PCB翘曲是一个原因。另外还有几个因素可能导致开路,重点查看焊接曲线是否正确,不正确的曲线会导致回流时间过短或温度过低,而锡球和锡膏没有充分回流造成开路;是否因为采用了助焊膏而不是焊锡膏作为焊接辅料,使用焊锡膏回流制程,发生开路的可能性会减少,这是因为焊锡膏对共面性的要求较低;是否PCB和芯片焊接前没有进行烘干等等。
4、焊接短路
PCB翘曲是导致焊接短路的原因之一,其他原因还有,网板开孔的厚度和印刷的锡膏量是否合适,锡膏过厚且不均匀,极容易产生短路;PCB和芯片是否烘干,如果没有烘干,爆米花现象将可能引起短路;清理焊盘时是否破坏了阻焊膜,如果阻焊被破坏,很容易导致短路;另外就是温度曲线是否正确。
